引言:“珠海高新招商”以招商运营为核心,聚焦珠海工业园区、珠海5.0产业园等招商引资工作,依托专业的招商团队和丰富的创新资源,为企业提供产业园入驻、平台搭建、产业政策咨询、科技服务等全流程专业服务。推动高新区招商引资工作走深走实,为高新区产业发展注入新动能。
“迄今为止全球集成电路封测行业由传统到先进可分为五个发展阶段,自第三阶段起的封装技术统称为先进封装技术。”
从产业链角度划分,半导体产业链可分为上游半导体设备及材料产业、中游半导体制造产业和下游应用产业,其中中游的半导体制造产业按照产品分类可分为光学光电子、传感器、分立器件和集成电路四大类,而集成电路又可分为逻辑芯片、存储芯片、模拟电路和微处理器四类。从市场规模占比来看,集成电路是半导体制造业的核心,占半导体行业规模的八成以上。

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
从制造工艺角度看,集成电路产业链从上至下可分为设计、制造和封测三大环节,其中集成电路封测是集成电路产品制造的后道工序。绝大部分芯片设计公司采用Fabless模式,本身无晶圆制造环节和封装厂测试环节,其完成芯片设计后,将版图交给晶圆代工厂制造晶圆,晶圆完工后交给下游封测企业,封测企业根据客户要求的封装类型和技术参数,将芯片裸晶加工成可直接装配在PCB电路板上的集成电路元器件。封装完成后,根据客户要求,对芯片产品的电压、电流、时间、温度、电阻、电容、频率、脉宽、占空比等参数进行专业测试。完成晶圆芯片的封装加工和测试后,封测企业将芯片成品交付给客户,获得收入和利润。
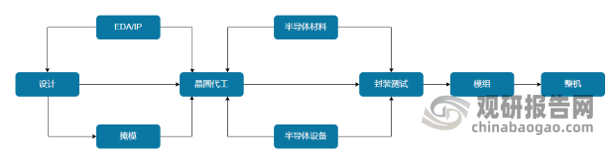
资料来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
根据《中国半导体封装业的发展》,迄今为止全球集成电路封测行业由传统到先进可分为五个发展阶段,自第三阶段起的封装技术统称为先进封装技术。当前,中国封装企业大多以第一、第二阶段的传统封装技术为主,例如DiP、SOP等,产品定位中低端;全球封装业的主流技术术处于以CSP、BGA为主的第三阶段,并向以系统级封装(SiP)、倒装焊封装(FC)、芯片上制作凸点(Bumping)为代表的第四阶段和第五阶段封装技术迈进。先进封装技术更迎合集成电路微小化、复杂化和集成化的发展趋势,是封测产业未来的发展方向。

资料来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
根据观研报告网发布的《中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)》显示,半导体制造中,工艺制程持续微缩导致晶体管密度逼近极限,同时存在短道沟效应导致的漏电、发热和功耗严重问题。工艺节点较高时,每次工艺节点的提高都会带来成本的非线性增加,在资本支出大幅提高的背景下,技术节点的变迁在逐渐变缓。根据国际集成电路技术发展路线图预测,未来半导体技术的发展将集中于三个方向:
(1)继续遵循摩尔定律缩小晶体管特征尺寸,以继续提升电路性能、降低功耗,即MoreMoore;
(3)整合SystemonChip(SoC,系统级芯片)与SysteminPackage(SiP,系统级封装),构建高价值集成系统。在后两个发展方向中,封装技术的重要性大幅增强。
从产业环节价值看,传统封测技术含量相对较低,但随着先进封测技术的发展演进,更加突出芯片器件之间的集成与互联,实现更好的兼容性和更高的连接密度,先进封测已然成为超越摩尔定律方向的重要赛道,让封测厂商与设计端、制造端联系更为紧密,进一步抬升封测环节的产业价值。

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
先进封装是在不要求提升芯片制程的情况下,实现芯片的高密度集成、体积的微型化,并降低成本,符合高端芯片向尺寸更小、性能更高、功耗更低演进的趋势。传统封装的功能主要在于芯片保护、电气连接,先进封装在此基础上增加了提升功能密度、缩短互联长度、进行系统重构的三项新功能。在后摩尔时代,人们开始由先前的“如何把芯片变得更小”转变为“如何把芯片封得更小”,先进封装成为半导体行业发展重点。
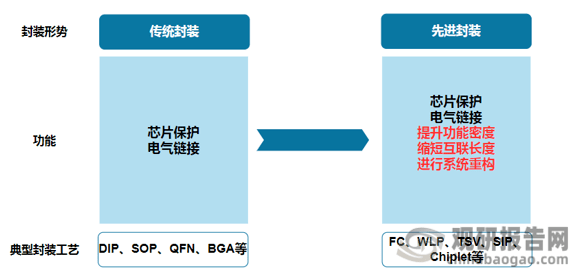
资料来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
随着5G通信技术、物联网、大数据、人工智能、视觉识别、自动驾驶等应用场景的快速兴起,应用市场对芯片功能多样化的需求程度越来越高。在芯片制程技术进入“后摩尔时代”后,先进封装技术能在不单纯依靠芯片制程工艺实现突破的情况下,通过晶圆级封装和系统级封装,提高产品集成度和功能多样化,满足终端应用对芯片轻薄、低功耗、高性能的需求,同时大幅降低芯片成本。因此,先进封装在高端逻辑芯片、存储器、射频芯片、图像处理芯片、触控芯片等领域均得到了广泛应用。
以系统级封装为例,现阶段,以智能手机为代表的移动消费电子领域是系统级封装最大的下游应用市场,占了系统级封装下游应用的70%。根据Yole预测,未来5年,系统级封装增长最快的应用市场将是可穿戴设备、Wi-Fi路由器、IoT物联网设施以及电信基础设施。尤其随着5G通讯的推广和普及,5G基站对倒装球栅阵列(FC-BGA)系统级封装芯片的需求将大幅上升,未来5年基站类系统级芯片市场规模年均复合增长率预计高达41%。

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
近年来,随着物联网、5G通信、人工智能、大数据等新技术的不断成熟,全球集成电路行业进入新一轮的上升周期,封测行业受益市场规模持续增长。根据WSTS数据,2021年全球集成电路封测行业市场规模为670亿美元,同比增长3.87%,2017-2021年复合增长率为2.97%,预计2022年市场规模有达到670亿美元。在中国,受益于半导体产业向中国大陆转移,中国封测市场快速发展。根据中国半导体协会数据,2021年中国封测产业市场规模为2743.44亿元,2017-2021年,中国大陆封测产业市场规模复合增长率为9.9%,增速高于全球。

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)
从先进封装占比来看,随着半导体封测市场规模持续增长,全球先进封装占比持续提升,根据YOLE数据,2021年全球先进封装占比已经达到45%,近年来先进封装市场规模增速要明显高于传统封装增速。我国先进封装渗透率低,但随着半导体行业的发展,近年来,国内厂商通过兼并收购,快速积累先进封装技术,目前封测厂商技术平台基本做到与海外同步,大陆先进封装产值占全球比例也在逐渐提升,由2015年的10.3%增长至2020年的14.8%。预计我国先进封装产值占全球比重有望进一步提高,2022年将达到16.8%。

数据来源:中国半导体封装行业发展趋势分析与投资前景研究报告(2023-2030年)